PAT 零部件平均测试

随着新能源和无人驾驶汽车快速发展,使得车规级芯片发挥着越来越重要的作用。相对于消费类电子芯片,车规芯片的质量要求更加苛刻。
AEC-Q001规范中提出了参数零件平均测试(Parametric Part Average Testing, PPAT)方法。PAT 是用来检测外缘(Outliers)半导体组件异常特性的统计方法,用以将异常组件从所有产品中剔除。
上扬软件PAT(Part Average Testing)零部件平均测试,不仅包括常见的静态SPAT(Static PAT)、动态DPAT(Dynamic PAT,还包括先进的区域聚集性PAT(Geographic PAT)剔除功能,使得PAT应用更加多样、科学。
区域聚集性PAT是为所有在晶圆上的裸晶加入邻近性权重,因此一些被不良裸晶包围或邻近的良好裸晶,可能会被移除。其核心思想是通过良品坐标周围的不良品数量,或者通过不良品...
区域聚集性PAT是为所有在晶圆上的裸晶加入邻近性权重,因此一些被不良裸晶包围或邻近的良好裸晶,可能会被移除。其核心思想是通过良品坐标周围的不良品数量,或者通过不良品的聚集性找出有风险的芯片。分别对应正向、反向两种搜索剔除算法。

动态PAT是根据当前Wafer测试参数的测试值计算当前WaferPAT参数的统计值(如中位数、均值、Sigma),再根据上下限的Sigma设置倍数得出上下PAT管控线,最后根据每个die的实测...
动态PAT是根据当前Wafer测试参数的测试值计算当前Wafer PAT参数的统计值(如中位数、均值、Sigma),再根据上下限的Sigma设置倍数得出上下PAT管控线,最后根据每个die的实测值与管控线得出die的Pass/Fail。

静态PAT根据测试历史数据计算产品PAT参数的统计值(如中位数、均值、Sigma),再根据上下限的Sigma设置倍数计算出上下PAT管控线,最后根据每个die的实测值与管控线得出die的Pass/Fail。
静态PAT根据测试历史数据计算产品PAT参数的统计值(如中位数、均值、Sigma),再根据上下限的Sigma设置倍数计算出上下PAT管控线,最后根据每个die的实测值与管控线得出die的Pass/Fail。

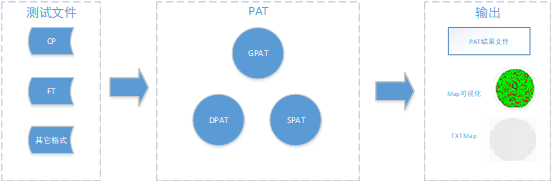
FA PAT支持多种测试文件格式,采用多线程技术,自动监听测试文件,输出PAT结果文件,也可直接将结果数据存储在数据库或推送给其它系统。
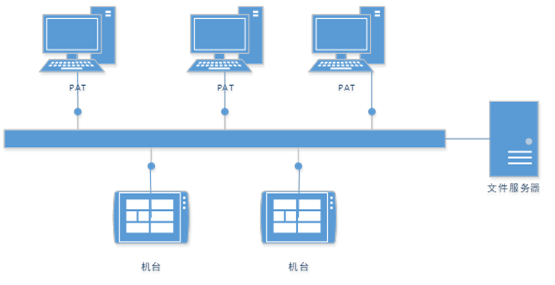
FA PAT与机台软件运行在同一局域网内,可直接访问文件服务器,自动对机台软件产生的测试文件进行PAT计算,从而产生结果文件,存储在文件服务器上。